深圳紫宸激光自动化设备制造商欢迎您! 客服热线:0755-237218454
芯片激光植球机:芯片焊盘设计的基本规则
激光焊接由实时温度反馈系统、CCD同轴定位系统和半导体激光器组成。在芯片制造过程中,激光光束可以达到微米级,加工时间程序控制,精度远高于传统加工方式。搭载自主研发的智能焊接软件,支持导入各种格式的文件。独创的PID在线温度调节反馈系统能有效控制焊料的恒温,保证焊料的成品率和精度,具有广泛的应用前景。

BGA器件的封装结构按焊点形状分为两类:球形焊点和柱状焊点。BGA封装技术是采用将圆型或者柱状焊点隐藏在封装体下面,其特点是引线间距大、引线长度短。
BGA焊盘设计
据统计,在表面贴装技术中,70%的焊接缺陷是由设计原因造成的。BGA:卷片组装技术也不例外,随着BGA芯片的锡球直径逐渐向0.5mm、0.45 mm、0.30 mm等小型化发展,印制板上焊盘的大小及形状直接关系到BGA芯片与印制板的可靠连接,焊盘设计对锡球焊接质量影响也逐渐增大。对同样的BGA芯片(球径0.5 mm,间距0.8 mm)采用相同的焊接工艺分别焊接在直径为0.4 mm、0.3 mm的印制板焊盘上,验证结果为后者出现BGA虚焊的比例高达8%。因此,BGA焊盘设计直接关系到BGA的焊接质量。标准的BGA焊盘设计如下:

A、阻焊层设计
设计形式一:阻焊层围绕铜箔焊盘并留有间隙;焊盘间引线和过孔全部阻焊。
设计形式二:阻焊层在焊盘上,焊盘铜箔直径比阻焊开孔尺寸大。
这两种阻焊层设计中,一般优选设计形式一,其优点是铜箔直径比阻焊尺寸容易控制,且BGA焊点应力集中较小,焊点有充分的空间沉降,增加了焊点的可靠。
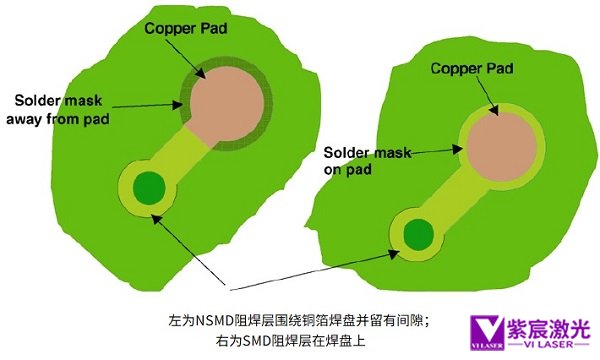
B、焊盘设计图形及尺寸
BGA焊盘与过孔采用印制线连接,杜绝过孔直接与焊盘连接或直接开在焊盘上。
BGA焊盘设计的一般规则:
(1)焊盘直径既能影响焊点的可靠性又能影响元件的布线。焊盘直径通常小于焊球直径,为了获得可靠的附着力,
一般减少20%--25%。焊盘越大,两焊盘之间的布线空间越小。如1.27mm间距的BGA封装,采用0.63mm直径焊盘,在焊盘之间可以安排2根导线通过,线宽125微米。如果采用0.8 mm的焊盘直径,只能通过1根线宽为125微米的导线。
(2)下列公式给出了计算两焊盘间布线数,其中P为封装间距、D为焊盘直径、n为布线数、x为线宽。P-D≥(2n+1)x
(3)通用规则为PBGA基板上的焊盘和PCB上焊盘直径相同。
(4)CBGA的焊盘设计要保证模板开口使焊膏漏印量≥0.08mm3。这是最小要求,才能保证焊点的可靠性。所以CBGA的焊盘要比PBGA大。
在一些薄型封装的元器件及热敏元件焊接时,电子元器件本身也被以很大的加热速度加热到锡焊温度,对元器件产生热冲击作用,存在被破坏的可能。而激...
2025成都国际工业博览会(CDIIF)即将于4月23日至25日在中国西部国际博览城盛大启幕!紫宸激光(展位号:16H-B035)作为高精度激光焊接领域的领军企业,将...
激光锡丝焊接机是一种高精度、非接触式的焊接设备,广泛应用于电子元器件、微电子封装、传感器、精密仪器等领域。其关键技术涉及激光技术、材料控...
在电子工业中,激光自动焊接电子元器件已经成为一种趋势。然而,在进行激光自动焊接时,我们需要注意以下几点:1、定位精度。精确的定位是至关重要...
激光焊锡机在电子制造中广泛应用,锡线成分影响PCB焊接性能。无铅焊料成主流,含银、铜、铋等元素改善性能。助焊剂关键,影响焊接质量和环保。需根...
激光焊锡机是一种利用高能量密度的激光束作为热源,对焊料(如锡丝、锡膏或锡球)进行局部加热,使焊料熔化并形成焊接连接的设备。不同的焊料形式...